半導體
半導體〈semiconductor〉,顧名思義,是導電力介於金屬等導體和玻璃等非導體間的物質。若以導電率來看,半導體大致位於103和10-10(ohm-cm)-1間〈當然這只是概分,這三者之間並沒有制式的界限存在〉。室溫下鋁的電阻值為2.5x10-6ohm-cm,而玻璃則幾乎為無限大。會有這種現象是因為物質內部電子分佈在不同的能量範圍〈能帶,energy band〉內,其中可讓電子自由移動的能帶稱為導帶〈conduction band〉,除非導帶內有電子可自由活動,否則物質將無法經由電子來傳導電流,其它能帶〈價帶,valence band〉的電子必須要克服能量障礙〈指能隙,energy bandgap〉,躍升至電導帶後,方可成為導電電子。例如玻璃,即是因為這能隙太大,使得電子在室溫下無法跳躍至導帶自由活動,所以是非導體。
至於半導體,其能量障礙不是很大,介於非導體與導體之間,所以在高溫、照光等給予能量的狀況或適量地加入一些可減小能量障礙的元素〈參質〉,便可改變其電阻值,成為電的良導體。電子工業便是利用半導體這種可隨環境、參質的加入等而改變其導電能力之特性,發展出多項的應用產品。
半導體的應用範圍很廣,包括二極體、電晶體等電子元件及發光二極體、雷射二極體、各類檢測器、太陽能電池等光電元件。除此之外,尚有功率元件,及目前相當熱門的各類顯示器都可以見到半導體的蹤跡。
半導體材料又可分為元素半導體〈element semiconductor〉及化合物半導體〈compound semiconductor〉。元素半導體是由單一元素所組成的半導體,如Si、Ge等;化合物半導體則是由兩種以上的元素所組成的半導體,如GaAs、ZnS等,常應用於光電或高速元件中。
1.NMOS製程步驟圖:
以下是NMOS製程的動畫圖,是元素參考〝VLSI製程技術--莊達人著--高立--ISBN 957-584-327-4--P396~P408〞中所述及的NMOS製程步驟所做,所以相信大家對於此動畫所呈現的各步驟應當不陌生。做成動畫後能更清楚地了解各步驟的順序及使用時機,若有不清楚的地方,也請參閱此書。
本動畫的製程所用到的光罩數為四,分別用來:
第一道:定義主動區
第二道:定義閘極區
第三道:定義接觸窗〈contact window〉
第四道:定義連線圖案
在此四道後,一般還有最後一道光罩,是用來定義與外界相接的銲電區〈pad window〉。不過限於時間,便沒有加上去,最後只長到護層〈passivation layer〉。另外,各層大小厚度比例並不正確,只能用來表示其相對位置而已。
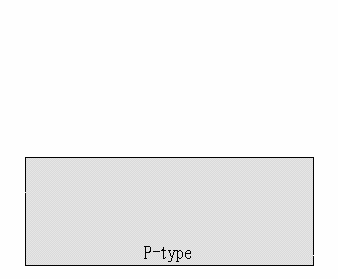
2.IC製作流程
整個IC製作的流程大概可分為為電路設計〈IC design〉、晶圓加工〈wafer fabrication〉、封裝〈packaging〉及測試〈test〉四大部份,其關係如下圖所示:
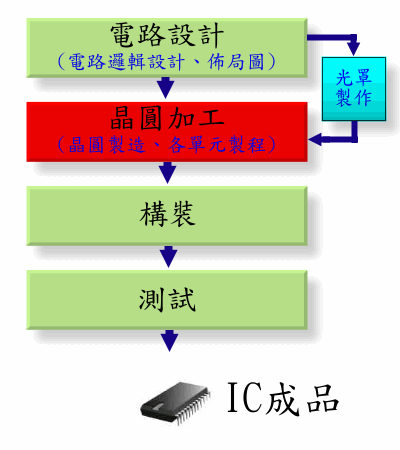
3.晶圓
晶圓,wafer,是VLSI製程中不可或缺的材料,IC上所有的元件都是〝長〞在這上面。晶圓也就是我們一般常聽到的底材〈substrate〉。
以矽晶圓來說,它的來源是石英〈主成份為氧化矽〉。剛開挖出來的石英礦,必須經過純化、高溫溶解、蒸溜、沉積等步驟,得到所謂高純度的矽棒〈silicon rod〉,但這時候的矽並非是結晶狀態,因此必須再以單晶成長方法來得到所需的單晶矽。常見的單晶成長法有拉晶法〈Czochralski、CZ法〉和浮游區域法〈Float Zone、FZ法〉。其中以拉晶法最為被廣泛使用,因為這種方法所需的成本較低,且容易達成大尺寸化;而FZ法所成長的矽晶錠〈silicon ingot〉,其雜質濃度一般會較低。
不管是用何種方法長成的晶錠,必須要經過grinding、slicing、lapping、etching、polishing、cleaning及inspection步驟,最後一片片的晶圓才會被包裝起來,以保持表面的無污染及平坦性。儘管如此,晶圓在使用之前,仍須經過化學物品的清洗,確保其表面品質。
晶圓的大小〈指其直徑〉由早先的三吋〈約7.5公分〉到目前的八吋〈約20公分〉,未來將朝的十二吋、十六吋等大尺吋方向前進,主要是為了提高VLSI的產能且提升IC的良率,以增加廠商自身的競爭力。
